碳化硅和氮化鎵為典型第三代半導體材料。
第三代半導體材料的特點:禁帶寬度大、發光效率高、電子漂移飽和速度高、熱導率高、硬度大、介電常數小、化學性質穩定以及抗輻射性能好、耐高溫等。
因此,其在高亮度發光二極管、紫外—藍光激光器和紫外探測器等光電子器件以及抗輻射、高功率、高頻、高溫、高壓等電子器件域有著巨大的應用潛力和廣闊的市場前景。
下面簡要介紹碳化硅襯底種類
碳化硅襯底根據導電性來分,可分為半絕緣型襯底(電阻率大于1E5 Ω?cm)和導電型襯底。
其中,
導電型碳化硅襯底可用于生長碳化硅外延片,主要應用于制造耐高溫、耐高壓的功率器件如IGBT;
半絕緣型碳化硅襯底可用于生長氮化鎵外延片,主要應用于微波射頻器件等領域。
本文淺介紹碳化硅襯底常用測量手段。
一、晶圓幾何參數測量
晶圓幾何參數主要包括晶圓厚度、TTV、和BOW/Warp等,一般常用測試方法為光學干涉法和電容法。
★ 光學干涉法具有測試速度快,精度高的特點,設備價格昂貴,主要被Corning公司所采用,其Tropel系列被廣泛應用于幾何參數量測。
測量原理:掠入式干涉

主要廠商:Corning Tropel
★電容法幾何參數測試儀相對成本較低,在硅片襯底中被廣泛采用,對碳化硅襯底同樣適用。
測量原理:電容測厚

主要廠商:MPI,E+H Metrology等
二、表面缺陷分析
碳化硅襯底的表面缺陷有表面顆粒、劃痕和晶格缺陷等,主要采用碳化硅晶圓缺陷系統測試。
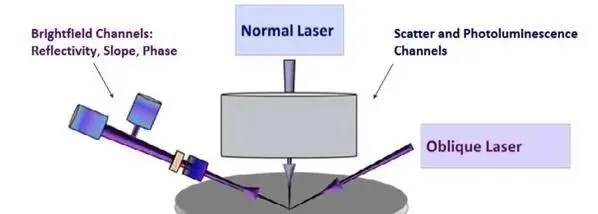
測量原理:電容測厚
利用激光在襯底表面的散射,可以分析襯底表面上的顆粒大小和缺陷形態,通過激光對襯底表面的面掃描,可以獲得襯底上顆粒和缺陷的面分布情況,同時在光致發光(PL)功能模塊的幫助下,可以進一步分析襯底內部的缺陷復合中心,為襯底質量評估提供更全面的信息。
主要廠商:KLA Candela,Lastertec, Horiba, Visiontec
三、表面粗糙度測量
表面粗糙度一般采用原子力顯微鏡(AFM) 和白光干涉儀(WLI)測量,可測試亞納米級粗糙度。
AFM測試原理:
將一個對微弱力極敏感的微懸臂一端固定,另一端有一微小的針尖,針尖與樣品表面輕輕接觸,
由于針尖尖端原子與樣品表面原子間存在極微弱的排斥力,通過在掃描時控制這種力的恒定,帶有針尖的微懸臂將對應于針尖與樣品表面原子間作用力的等位面而在垂直于樣品的表面方向起伏運動。
利用光學檢測法或隧道電流檢測法,可測得微懸臂對應于掃描各點的位置變化,從而可以獲得樣品表面形貌的信息。
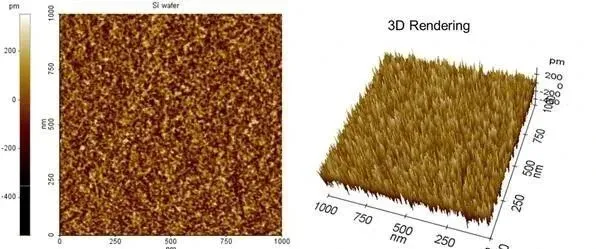
主要廠商:Bruker、Park System等
WLI測試原理:
基于白光干涉現象,通過分析被測表面與參考鏡面反射光的光程差引起的干涉條紋變化,精確計算表面微觀高度差,從而獲取粗糙度參數。
主要廠商:Taylor Hobson、Bruker等
四、電阻率和摻雜濃度
- 導電型碳化硅的電阻率是通過渦流法進行檢測的,導電線圈在導電襯底上形成渦流,渦流產生磁場變化被傳感器偵測到,可以計算出襯底的方塊電阻,渦流的檢測原理如下:

主要廠家:Semilab,KITEC,Napon
- 半絕緣型碳化硅的電阻率是通過電容放電法進行檢測的,設備為非接觸高阻測試儀
測試原理:
電容探針法,在襯底上施加電壓的瞬間,通過偵測電荷的變化,來計算襯底的電阻率。
應用:摻雜濃度,電阻率等
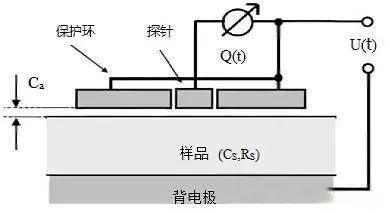
主要廠家:Semilab,EuroRad
五、晶型和結晶質量測試
晶型:不同結晶組分的碳化硅在襯底中的分布是通過對襯底面掃描獲得Raman信號來實現的。
由于4H晶型和6H晶型的碳化硅具有不同的Raman信號峰,因此通過選定峰位范圍的光強收集,可以區分出不同區域的晶型。

結晶質量:通過測量X射線搖擺曲線,獲得襯底或者晶體某一晶面的衍射峰強度和角度分布,根據衍射信號半峰寬的大小來判定晶面間距的一致性,進而判定結晶質量。
六、位錯密度和微管密度
要獲取碳化硅襯底位錯密度和微管密度分布的信息
- 首先在高溫熔融氫氧化鉀中腐蝕碳化硅襯底片,
- 然后在光學顯微鏡或者類似的光學成像系統中,進行分區域的圖像識別,并計算單位面積(視場)的對應缺陷密度,由于不同的缺陷類型,如螺位錯(TSD)、刃位錯(TED)、基平面位錯(BPD)和微管(MPD)有自己的典型圖案特征,因此可以通過計算機圖像識別加以區分。
主要設備為微分干涉顯微鏡。

總結
碳化硅襯底需要多種測量手段配合,這些測量手段不可或缺,通過監控產品質量進而不斷改進工藝,提高產品良率,從而保證器件質量。
聯系我們
- 蘇州同創電子有限公司
- 電話:133 8218 2805
- 官網:www.gzmbit.cn





